厦门大学&杭光所&上光所&复旦大学&吉林大学等团队:β-Ga₂O₃薄膜外延生长与掺杂技术的最新进展与展望综述
由厦门大学张洪良教授、龙浩教授联合杭州光机所齐红基研究员、吉林大学董鑫教授、复旦大学方志来教授和上海光机所陈端阳高级工程师等人的研究团队在学术期刊 APL Materials 发布了一篇名为 Recent advancement and perspective of epitaxial growth and doping of β-Ga2O3 thin films for power electronics(β-Ga2O3 薄膜外延生长与掺杂技术的最新进展与展望综述)的文章。
一、 项目支持
该综述由中国国家重点研发计划(2022YFB3605501)、深圳市科技创新委员会(JCYJ20220530143016036)以及国家自然科学基金委员会(22275154)提供的资金支持。
二、 背景
β-氧化镓(β-Ga2O3)是一种前景广阔的超宽禁带(UWBG)半导体材料,因其卓越的物理特性,在下一代高功率电子器件和日盲深紫外(DUV)光电器件领域备受关注。β-Ga2O3 的核心优势包括:超宽的禁带(约 4.8 eV)以及极高的理论击穿场强(约 8 MV/cm)。最重要的一点是,可以通过成本相对低廉的熔体法生长出高质量的大尺寸体单晶衬底。外延生长技术是在这些衬底上制备具有可控厚度、精确掺杂浓度和低缺陷密度的高质量薄膜的关键,是制造高性能器件的基础。本文旨在全面综述 β-Ga2O3 薄膜外延生长的最新研究进展,重点介绍不同的外延技术和在不同晶向衬底上的生长特性,并展望未来的发展方向。
三、 主要内容
氧化镓因其卓越的材料特性备受关注,包括 4.9 eV 的超宽禁带、8 MV/cm 的高击穿电场,以及可通过熔融法生长出大尺寸块体晶体。这些优势使 Ga2O3 成为高功率电子学和日盲紫外光电应用的理想材料。近年来,在单晶衬底生长、薄膜外延及器件制造领域取得重大进展。薄膜外延作为释放 Ga2O3 器件潜能的关键环节,可实现载流子掺杂浓度、界面特性及缺陷最小化的精确调控。本文综述了采用分子束外延、金属有机化学气相沉积、氢化物气相外延及其他生长技术在 Ga2O3 薄膜外延生长领域的最新进展。首先探讨 Ga2O3 在电子器件应用中的关键材料特性,随后简要回顾单晶衬底熔融生长现状。随后重点聚焦薄膜外延生长技术的最新进展,着重阐述掺杂对电学特性的调控、缺陷最小化与控制技术,以及面向二维电子气发展的 (AlxGa1−x)2O3/Ga2O3 异质界面构建进展。
四、 结论
得益于 Ga2O3 卓越的材料特性,以及通过经济高效的熔融法可获得大尺寸块体单晶,近年来在块体晶体生长、衬底工艺、薄膜外延及器件制造方面取得了显著进展。本文综述了 Ga2O3 材料性能的基础认知,以及体单晶合成、薄膜外延、掺杂与缺陷控制等领域的最新进展。
近年来,体晶衬底开发取得重大突破。EFG 法已实现直径达 6 in. 的大尺寸 β-Ga2O3 晶圆生产,位错密度低至 104 cm−2。此外,CZ 法、VB 法及铸造法等其他生长技术也得到广泛探索。例如:采用铸锭法已成功合成 8 in. 晶体,VB 法与 CZ 法则分别制备出 6 in. 和 2 in. 晶体。6 in. 衬底与外延晶片有望成为代工厂批量生产的标准尺寸。为使 Ga2O3 具备与 SiC 的竞争力,关键在于进一步降低衬底成本。此外,衬底缺陷密度仍相对较高,亟需开展基础研究并开发无损缺陷检测技术。
Ga2O3 薄膜的外延生长及掺杂调控方面亦取得显著进展。高压气相外延技术展现出高生长速率,目前已实现 4 in. 晶圆上 10-15 μm 厚薄膜的量产与商业化。但氯污染和表面粗糙度等问题仍需通过化学机械抛光技术解决。此外,高压气相外延技术在进一步降低成本方面可能面临局限。鉴于金属有机化学气相沉积技术在 GaN 低成本、高效率量产方面的成功经验,该技术正逐渐受到 Ga2O3 外延领域的关注。最新研究证实,通过主要采用硅掺杂剂,可在 (010) 和 (100) 衬底上生长出高质量 Ga2O3 薄膜,其迁移率可达 200 cm2/V·s,载流子浓度可控范围为 1015 至 1020 cm−3。然而,这些薄膜通常生长在厚度小于 8 μm 的小尺寸衬底上,且生长速率相较于高压气相外延 (HVPE) 技术仍显偏低。金属有机化学气相沉积 (MOCVD) 技术的下一步突破,在于实现更大尺寸晶圆(> 4 in.)厚度 > 10μm、生长速率 > 5μm/h 的薄膜制备,从而为大规模量产奠定成本效益基础。此外,大尺寸缺陷(致命缺陷)的高密度仍构成挑战,需进一步研究解决。持续降低缺陷(特别是孪晶、堆垛错位及大颗粒)对提升器件可靠性与性能至关重要。尽管分子束外延(MBE)生长速率较慢(< 1 nm/h),但其在原子级薄膜生长控制方面具有卓越优势。该特性可制备出缺陷密度低、掺杂分布均匀、界面清晰的高质量外延层。MBE 工艺尤其适用于制造射频器件所需的 (AlxGa1−x)2O3/Ga2O3 二维电子气系统。
尽管取得这些进展,β-Ga2O3 仍存在两大根本局限:缺乏有效的 p 型掺杂手段并且热导率较低。缺乏具有合理空穴导电性的 p 型材料,对 β-Ga2O3 器件结构设计造成显著制约。此外,其低热导率严重影响散热性能,对高功率器件应用构成重大挑战。

图1.(a) 半导体带隙能量与击穿电场关系图。(b) 基于电流和电压需求的 SiC、GaN 及 Ga2O3 在电力电子领域的应用。

图 2. 基于 Ga2O3 材料的主要器件应用。
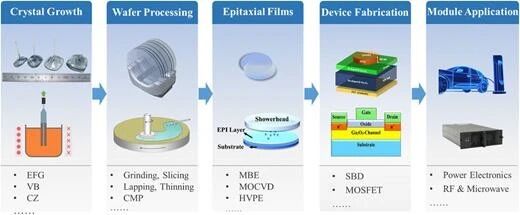
图 3. 基于 Ga2O3 的材料和器件的制造工艺。

图 4. (a)单斜 β-Ga2O3 晶体结构。蓝色和品红色虚线分别表示(100)和(001)表面切面。“A”和“B”表示不同的表面终止。(100)和(001)表面切面的原子排列分别用蓝色和品红色虚线框表示。(b)(010)表面切面(黑色虚线)和(010)表面切面的原子排列(黑色虚线框)。(c)(-201)表面切面(绿色虚线)和(-201)表面切面的原子排列(绿色虚线框)。

图 5. (a)通过杂化密度泛函理论计算得出的 β-Ga2O3 的能带结构。(b)Ga2O3 的示意图能级图,展示了源自 Ga 4s 的导带和源自 O 2p 的价带。
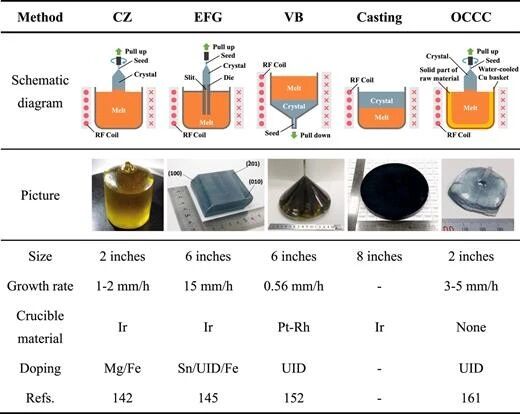
图 6. 不同方法生长块状β-Ga2O3 晶体的示意图、图片及参数。
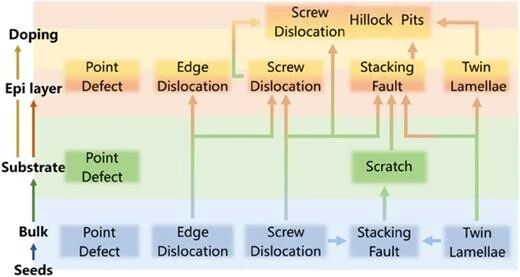
图 7. Ga2O3 外延生长过程中各种类型缺陷的示意图。

图 8. 典型的 HVPE 系统:(a)示意图和(b)实物图。

图 9. (a)化学机械抛光原理图。(b)外延生长的同质外延层表面。(c)经化学机械抛光处理的同质外延层的蚀刻表面。
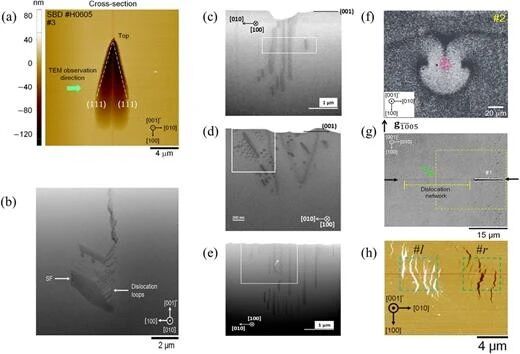
图 10.(a)H3PO4 蚀刻后在堆垛层错处形成的心形蚀刻坑的 AFM 表面图像;(b)由气相微粒诱导缺陷形成的亮点的截面 STEM 图像;(c)和(e)KOH + NaOH 熔融溶液蚀刻后在堆垛层错处形成的 1 - 3 型缺陷的截面 BF-STEM 图像;(f)SBD(黑/白对比)的同步辐射 X 射线形貌图像,叠加了多晶缺陷 No. 2 的 DICM 图像(粉红对比)。(g)线状缺陷的高倍率 DICM 图像;(h)探针压力下形成的表面缺陷的 AFM 图像。
DOI:
doi.org/10.1063/5.0271220
本文转发自《亚洲氧化镓联盟》订阅号
