NCT技术总监佐佐木公平团队联合及佐贺大学:堆垛层错引起的(001)β相氧化镓(100)微裂纹及SBD反向漏电流研究
由日本Novel Crystal Technology技术总监佐佐木公平团队联合佐贺大学的研究团队在学术期刊 Journal of Applied Physics 发布了一篇名为 (100) Microcracks induced by (1 ± 11) stacking faults in halide vapor deposited (001) β-Ga2O3: Origin of reverse leakage current in Schottky barrier diodes observed by high-sensitive emission microscopy and synchrotron x-ray topography(卤化物气相沉积 (001) β-Ga₂O₃ 中 (1 ± 11) 堆垛层错诱发的 (100) 微裂纹:通过高灵敏发光显微镜与同步辐射 X 射线拓扑观察肖特基势垒二极管反向漏电流的成因)的文章。
一、 背景
本研究聚焦于 β-Ga2O3 这种超宽禁带半导体材料。β-Ga2O3 具有4.8 eV的带隙和高达8 MV/cm的击穿电场,被认为是高功率、高效率电子器件的理想候选材料。目前,通过 Si 或 Sn 掺杂可实现 n 型 β-Ga2O3,并在肖特基势垒二极管(SBD)中已展现出优异的性能,如高达 2.89 kV 的击穿电压和低导通电阻。这些高性能器件通常依赖卤化物气相外延(HVPE)技术生长的高质量 β-Ga2O3 外延层。然而,尽管 HVPE 能实现快速生长和高品质晶层,器件中仍存在导致反向漏电流升高、击穿电压降低的“致命缺陷”,其形成机理尚未明确。过去研究已识别出多种缺陷类型,包括空洞、多晶区、堆垛层错、位错及表面沟槽等。基于此,本研究进一步发现 HVPE 生长的 (001) β-Ga2O3 外延层中存在由堆垛层错诱发的微裂纹,并首次揭示其晶面特征及周围的位错网络结构,从而阐明了此类微裂纹在 SBDs 中引起高反向漏电的关键作用。
二、 主要内容
本研究报道了在卤化物气相外延(HVPE)法生长的 (001) β-Ga2O3 外延层中存在的微裂纹,是肖特基势垒二极管(SBD)中的致命缺陷。这些微裂纹为 (100) 取向,典型长度为 1.7–5.1 μm,深度为 0.48–2.2 μm。它们伴随着 (111) 或 (1-11) 堆垛层错及位错网络的形成,导致 SBD 中出现较大的反向漏电流。堆垛层错在 HVPE 生长过程中产生,而微裂纹则被认为是在生长或退火过程中,由 [100] 与 [010] 方向热膨胀系数差异所引起的拉伸应变导致的。在反向偏压 −80 V 下,微裂纹底部的电场强度可达 6.0 MV/cm,从而在 SBD 中产生反向漏电流。
三、 总结
在本研究中,发现在 EFG (001) β-Ga2O3 衬底上通过 HVPE 法生长的 (001) β-Ga2O3 外延层中出现的微裂纹是肖特基势垒二极管(SBD)中的致命缺陷。这些微裂纹为 (100) 取向,典型长度为 1.7–5.1 μm,深度为 0.48–2.2 μm。它们由堆垛层错引起,并形成反向漏电流通道 [在 −80 V 下为 896 nA(8.87 μA/cm2)]。这些堆垛层错为 (1±11) 晶面,表明其在 HVPE 生长过程中产生。随后,在微裂纹和堆垛层错周围观察到了位错网络的形成。
通过模拟,证明微裂纹末端的电场在 −80 V 下集中达到 6.0 MV/cm,约为平坦表面的五倍。这表明 HVPE 层中微裂纹末端的电场集中是引发 SBD 反向漏电流的主要原因。
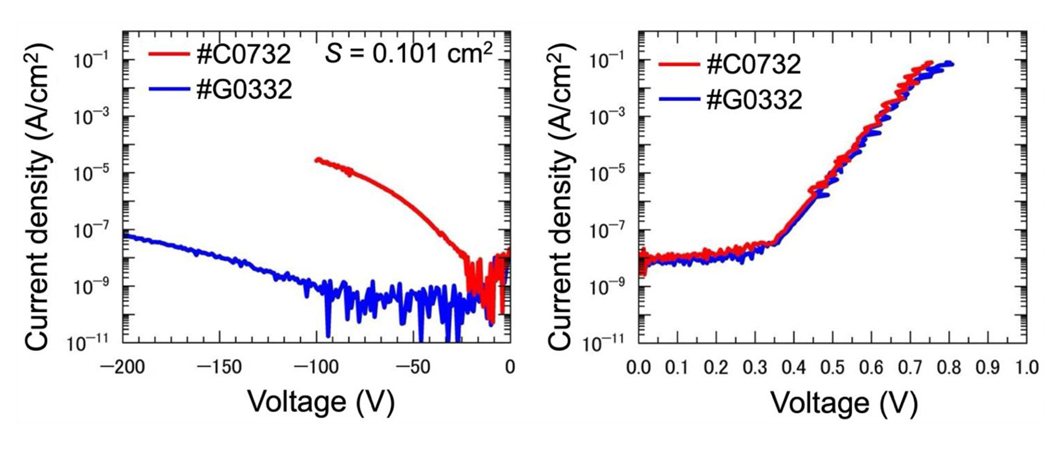
图 1. 同一晶圆上具有相同宽度(3200 μm,对应面积为 1.01 × 10-1 cm2)的方圆形(squircle)肖特基势垒二极管(SBD)#C0732(红色)和 #G0332(蓝色)的 I–V 特性曲线。

图 2. (a) SBD #C0732 在 −80 V 反向偏置下的发光显微镜图像,测得电流为 896 nA。颜色条表示光强。 (b) 发光图案 #1 和 #6 区域的放大图。
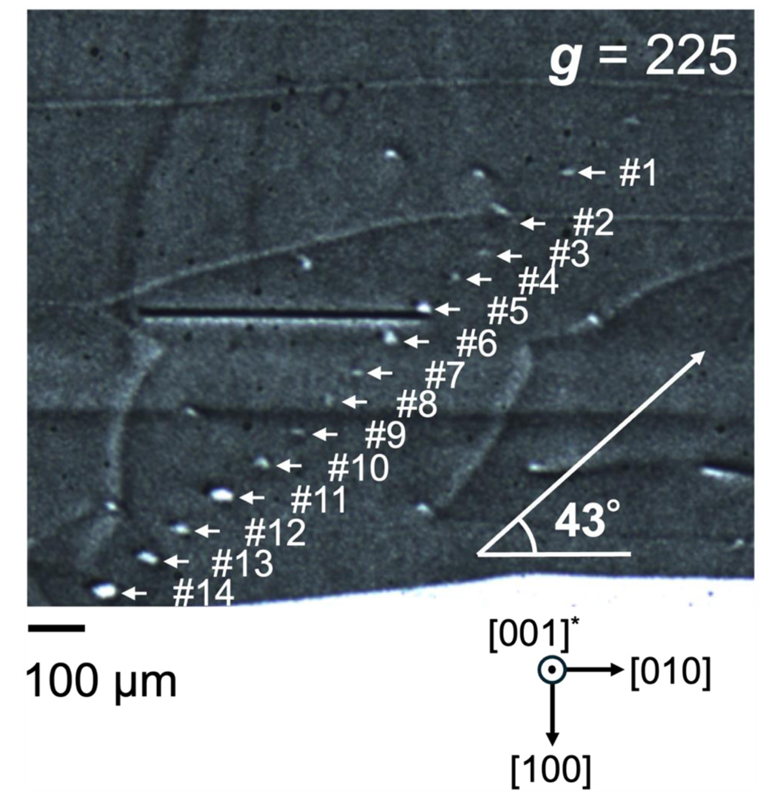
图 3. 对 SBD #C0732 进行 g = 225 衍射条件下的 X 射线拓扑图像。箭头所示为对齐缺陷的位置。

图 4. (a) 缺陷 #1 的 SEM 图像,由微裂纹 (MCs) #1-1 和 #1-2 组成;(b) MC #1-1 和 MC #1-2 的横截面 SEM 图像,以及相应的 β-Ga2O3 晶体结构。位置及 SEM 观察方向如 (a) 所示。
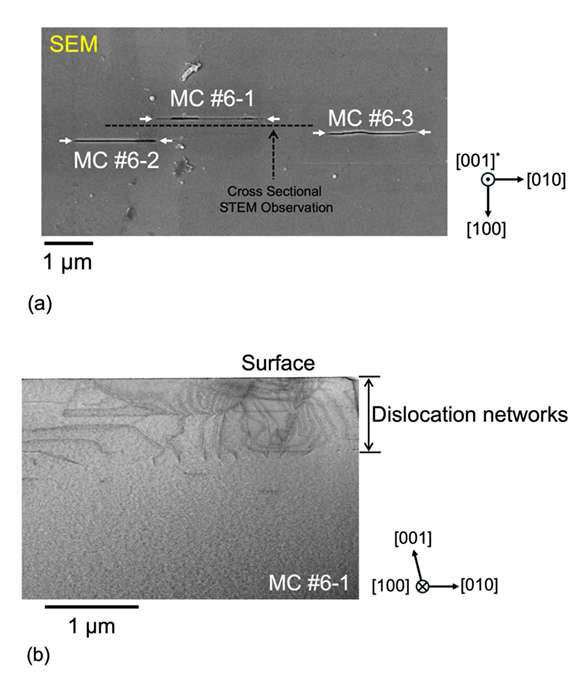
图 5. (a) 缺陷 #6 的 SEM 图像;(b) MC #6-1 的横截面 STEM 图像。位置及 STEM 观察方向如 (a) 所示。
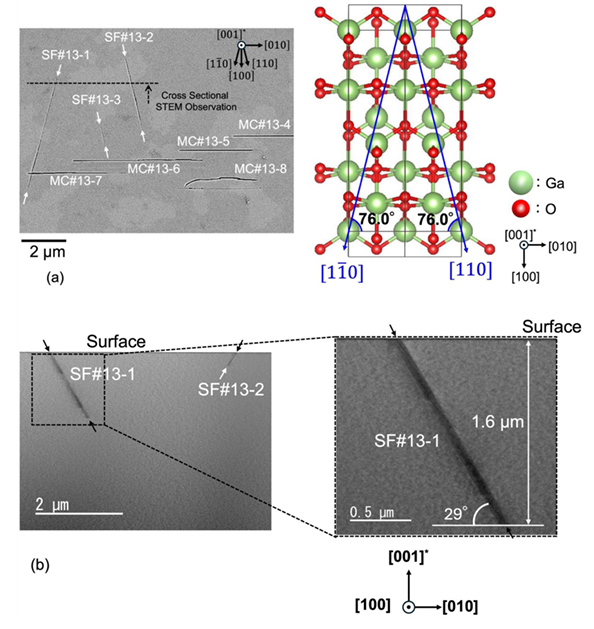
图 6. (a) 缺陷 #13 的 SEM 图像及 β-Ga2O3 晶体结构;(b) SFs #13-1 和 #13-2 的横截面 STEM 图像。位置及 STEM 观察方向如 (a) 所示;(c) SF #13-1 的横截面 STEM 图像绕 [001]* 轴逆时针旋转 12.6° 及相应 β-Ga2O3 晶体结构逆时针旋转 14°;(d) SF #13-2 的横截面 STEM 图像绕 [001]* 轴顺时针旋转 14.5° 及相应 β-Ga2O3 晶体结构顺时针旋转 14°。
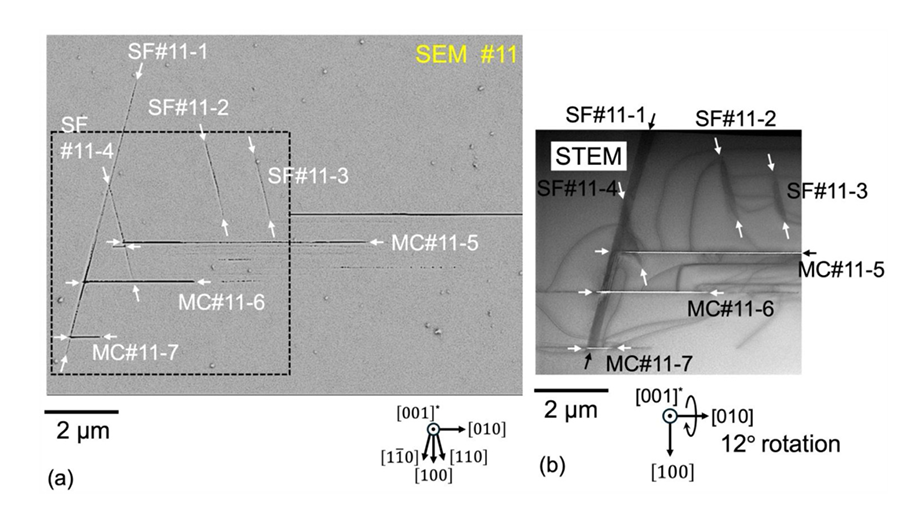
图 7. (a) 缺陷 #11 的 SEM 图像;(b) 缺陷 #11 绕 [010] 轴逆时针旋转 12° 的 STEM 明场图像。

图 8. 在反向偏压 −80 V 下,MC #1 横截面的电场分布模拟图。
DOI:
doi.org/10.1063/5.0294493
本文转发自《亚洲氧化镓联盟》订阅号
