日本大阪大学:SiO₂/β-Ga₂O₃(001) MOS结构中电子陷阱与固定电荷的氢钝化作用
由日本大阪大学的研究团队在学术期刊 Applied Physics Letters 发布了一篇名为 Hydrogen passivation of electron traps and fixed charges in SiO2/β-Ga2O3(001) MOS structures(SiO2/β-Ga2O3(001) MOS结构中电子陷阱与固定电荷的氢钝化作用)的文章。
一、 背景
β-氧化镓(β-Ga2O3)具有宽带隙(4.9 eV)和高击穿电场(8 MV/cm),使其成为下一代功率半导体材料的理想候选者。β-Ga2O3 体晶的生长工艺(如导模法和提拉法)无需高压环境,相较于其他宽带隙半导体可显著降低制造成本。通过氢化物气相外延技术可生长单晶 β-Ga2O3 外延层,其施主浓度可在 1015–1019 cm−3 的宽范围内调控。尽管具备这些优势,Ga2O3 仍存在导热性低及实现 p 型导电的挑战。前者问题可通过将 Ga2O3 置于碳化硅等高导热材料之上进行补偿。至于后者,解决方案是在器件结构中采用半绝缘区替代 p 区。迄今已报道了多种功率器件,包括垂直肖特基势垒二极管、耗尽型金属氧化物半导体场效应晶体管(MOSFET)以及超结等效 MOSFET,这凸显了业界对 Ga2O3 日益增长的关注。
在本研究中,研究团队探讨了金属化后形成气体退火(FG-PMA)对SiO2/β-Ga2O3 MOS 结构界面及介电特性的影响。在 Si MOS 结构中,已知 FG 退火会引入氢原子,这些氢原子能有效终止 SiO2/Si 界面处的硅悬键(Pb 中心)。氢原子同样能有效钝化 SiO2/SiC 界面处的碳悬键(PbC 中心)。尽管 Ga2O3 作为离子键半导体与上述共价半导体性质不同,但 FG-PMA 工艺在半导体技术中的广泛应用仍使其研究具有重要意义。
二、 主要内容
研究团队对金属化后形成气体退火(FG-PMA)对 SiO2/β-氧化镓[β-Ga2O3 (001)] MOS 结构的影响进行了研究。发现相对较低的 FG-PMA 温度(200–400℃)能有效减少界面及近界面缺陷,从而提升器件性能与可靠性。通过在 O2 和 N2 气氛中进行沉积后退火处理后实施 FG-PMA,Ga2O3 导带边缘附近的界面态密度降至 (4–7)×1010 eV−1 cm−2 的极低水平。电学性能的显著提升归因于氢原子对电学缺陷的钝化作用。
三、 结论
对 FG-PMA 在 SiO2/β-Ga2O3 (001) MOS 结构中效应的研究证实:在相对较低的温度(200–400℃)下,FG-PMA 可有效减少界面缺陷、固定电荷及近界面氧化物陷阱。通过在 O2 和 N2 联合退火后实施 FG-PMA 处理,Ga2O3 导带边缘附近的界面态密度降至 (4–7)×1010 eV−1 cm−2 的极低水平。这些电学性能的提升归因于氢原子对缺陷的钝化作用。
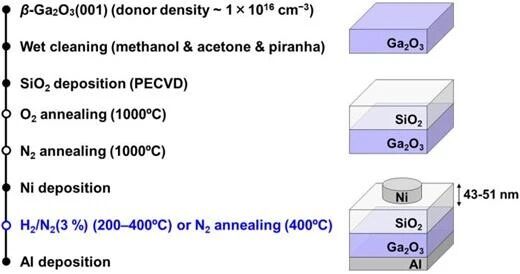
图1. Ga2O3 MOS结构的制造流程。

图2. (a) 在 1 MHz 频率下测得的 Ga2O3 MOS 结构双向 C-V 特性曲线。测量过程中电压扫描速率约为 1 V s−1。(b) 不同 PDA 气氛处理下 Ga2O3 MOS 结构的漏电流密度-氧化层电场特性曲线。

图3. (a) 在 1 MHz 频率下测得的 Ga2O3 MOS 结构双向 C-V 特性曲线。测量期间电压扫描速率约为 1 V s−1。图中同时标注了理想 C-V 特性曲线。(b) 基于双向 C-V 特性曲线评估的 FG-PMA 处理样品 C-V 滞后现象。(c) 经 FG-PMA 处理样品中观测到的平带电压偏移。平带电压偏移值通过正向 C-V 特性与理想特性曲线间的差值计算得出。
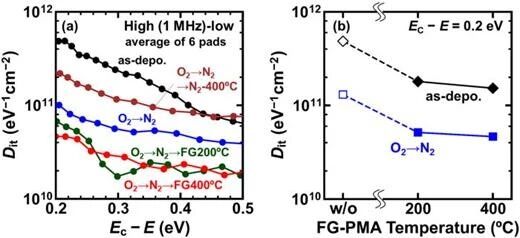
图4. (a) 采用 high (1 MHz)-low 法评估的 Ga2O3 MOS 结构中 Dit 分布。(b) EC−E=0.2 eV 时 Dit 随 FG-PMA 温度变化的关系曲线。

图5. Ga2O3 MOS 结构的漏电流密度-氧化层场特性曲线。
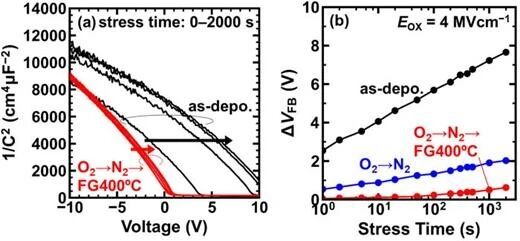
图6. (a) 应力测试测量期间的 1/C2–V 特性曲线(应力时间:0、100、1000和2000秒)及(b) Ga2O3 MOS结构中平带电压漂移的应力时间依赖性。测量期间的电压扫描速率约为1 V·s−1。
DOI:
doi.org/10.1063/5.0287823
本文转发自《亚洲氧化镓联盟》订阅号
