西安电子科技大学郝跃院士、张进成教授团队:β-Ga₂O₃异质结肖特基二极管的提案与仿真:低功函数阳极与高击穿电压
由西安电子科技大学的研究团队在学术期刊 IEEE Journal of the Electron Devices Society 发布了一篇名为 Proposal and Simulation of β-Ga2O3 Hetero-Junction Schottky Diodes With Low Work-Function Anode and High Breakdown Voltage(β-Ga2O3 异质结肖特基二极管的提案与仿真:低功函数阳极与高击穿电压)的文章。
1. 背景
β-Ga2O3 是适用于高功率和高频电子应用的半导体材料,这得益于其独特的材料特性,例如其超宽带隙(4.5-4.9 eV)带来的高临界电场(Ec)约为 8 MV/cm, 良好的本征电子迁移率(约 200 cm2V-1 s-1)以及高电子饱和速度(约 2×107 cm/s),这些特性使 Ga2O3 的理论巴利加优值(BFOM)和 Johnson 优值(JFOM)比 SiC 和 GaN 高出数倍。除这些优异材料性能外,β-Ga2O3 在材料生长方法上也具有优势。β-Ga2O3 单晶可通过熔融生长法制备,这使得低成本、大尺寸且与商业兼容的高质量衬底的生产成为可能。这同时实现了高质量同质外延生长,并揭示了 β-Ga2O3 在未来广泛应用于高功率领域的巨大潜力。
2. 主要内容
在本研究中,研究人员提出了一种具有低导通电压(Von)和高击穿电压(BV)的 p-NiO/n-Ga2O3 异质结(HJ)肖特基势垒二极管(SBD),并以沟槽型 SBD 作为对照。其电学特性通过 Sentaurus TCAD 进行模拟分析。HJ SBD 采用低功函数阳极金属形成顶部电极,以降低二极管正向状态下的 Von。通过采用鳍状结构及金属/半导体(M/S)结或 PN 异质结,实现了反向状态下 BV 的提升。本研究还对通过修改结构参数优化器件电学特性的尝试进行了全面分析。HJ SBD 同时实现了 0.57 V 的低 Von 和 3.79 GW/cm2 的功率优值(P-FOM)。所提出的结构为实现具有高反向阻断能力和低损耗性能的高性能 β-Ga2O3 SBD 提供了新途径。
3. 结论
通过 Sentaurus TCAD 模拟,提出了具有低 Von 和高 BV 的 p-NiO/n-Ga2O3 HJ SBD 结构并进行了研究。本研究系统性地探讨了在不显著牺牲 BV 的前提下,降低器件 Von 的策略。具体实现方式包括调整顶部阳极的工作函数,以及采用肖特基接触或具有鳍状结构的 HJ 来辅助鳍侧壁耗尽层的形成。通过优化器件参数,模拟得到 HJ SBD 在 RHW 为 0.12、WFin 为 5 μm、WSpace 为 3 μm、TNiO 厚度为 300 nm 以及顶部金属 SBH 为 0.9 eV 的条件下,典型 Von 值为 0.57 V,P-FOM 为 3.79 GW/cm2。文献表明,与 β-Ga2O3 结合的 Ti 和 Mo 等金属形成的肖特基接触具有与预测值接近的肖特基势垒高度。此外,未来表面处理技术的进步可能进一步降低 M/S 接触的肖特基势垒高度,使其与预期目标相一致。因此,本文所述结构被认为能够实现低 Von 和高 BV 的双重目标,适用于未来高功率和低损耗应用。
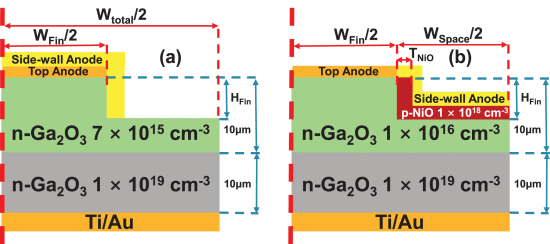
图1. 低功函数阳极位于鳍顶部的(a)沟槽型 SBD 和(b)p-NiO/n-Ga2O3 HJ型 SBD 的示意性截面图。
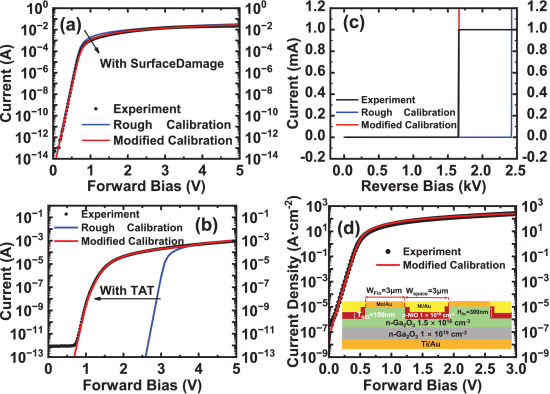
图2. 基于(a)β-Ga2O3 平面 SBD 的正向特性、(b)正向特性、(c)p-NiO/n-Ga2O3 HJ二极管的反向特性以及(d)p-NiO/n-Ga2O3 HJ 沟槽 SBD 的正向特性对模拟模型和参数进行校准。
DOI:
doi.org/10.1109/JEDS.2025.3556408
本文转发自《亚洲氧化镓联盟》订阅号
