西安电子科技大学郝跃院士、张进成教授团队:β-Ga₂O₃肖特基二极管单粒子效应分析
由西安电子科技大学的研究团队在学术期刊 Applied Physics Letters 发布了一篇名为 Analysis of the Single Event Effects in β-Ga2O3 Schottky Barrier Diodes(β-Ga2O3 肖特基二极管单粒子效应分析)的文章。研究团队来自西安电子科技大学宽禁带半导体器件与集成技术全国重点实验室、宽禁带半导体国家工程研究中心,团队以郝跃院士为首席科学家,先后获得国家首批国防科技创新团队、西安电子科技大学优秀创新团队、全国高校黄大年式教师团队等称号。文章通讯作者为西安电子科技大学张进成教授、赵胜雷教授和宋秀峰助理研究员,第一作者为桂娟硕士研究生。
1. 背景
β-Ga2O3 是一种新兴的超宽禁带(4.8–4.9 eV)半导体材料,凭借其极高的击穿电场(>8 MV/cm)、优异的热稳定性和出色的 Baliga 品质因子,成为高功率和辐照环境下电子器件的理想候选材料。在空间、核能等复杂辐射环境中,材料对高能粒子(如重离子)的抗扰动能力至关重要。尽管已有部分研究探讨了 Ga2O3 材料在不同粒子类型(如X射线、γ射线、质子)下的辐照响应,但系统研究其在高能重离子照射下的单粒子效应仍较少,尤其缺乏考虑器件在工作偏压下运行状态的实验数据。这使得当前对 Ga2O3 器件在极端辐射环境中可靠性的理解存在较大空白,亟需开展深入的实验与机制研究。
2. 主要内容
本研究聚焦于垂直结构 β-Ga2O3 肖特基二极管(SBD)在高能重离子辐照下的单粒子效应响应机制。具体而言,器件在施加 100 V 反向偏压的状态下,接受 LET = 37.9 MeV·mg-1·cm2 的 Kr 离子照射。通过测量器件的正向与反向 I-V 特性、C-V特性变化,并结合深能级瞬态谱(DLTS)技术捕捉辐照诱导的陷阱态变化,进而从微观机制角度解释器件性能退化原因,揭示退化机制。
3. 创新点
● 首次在高 LET 与工作偏压下系统研究 Ga2O3 SBD 的 SEE 响应
本工作在 Kr 离子 LET 达 37.9 MeV·mg-1·cm2、器件施加 100 V 反偏的工作状态下,系统开展 β-Ga2O3 肖特基二极管的 SEE 实验,填补了以往研究仅在零偏压或低 LET 条件下进行的局限,为实际空间应用提供更具代表性的实验数据。
● DLTS 揭示辐照缺陷特征
通过深能级瞬态谱(DLTS)分析,揭示辐照引起的已有缺陷能级(E1: EC-0.50 eV,E2: EC-0.65 eV)浓度大幅增加,并发现新陷阱能级(E3: EC-0.724 eV),构建“辐照→缺陷→性能劣化”的微观路径图。
● 构建 PFE 主导的反向漏电机制
构建了辐照诱导缺陷通过 Poole–Frenkel 发射机制增强反向漏电的物理模型,分析了辐照诱导陷阱对漏电路径的贡献。
4. 总结
在高能 Kr 离子辐照下,β-Ga2O3 SBD 的正向导通特性基本保持稳定,但其反向特性显著劣化,表现为反向漏电流显著上升。DLTS 结果显示,辐照不仅提升了原有陷阱(EC-0.50–0.53 eV 与 EC-0.65–0.693 eV)的浓度,还诱导了新的能级陷阱(EC-0.724 eV)。这些陷阱显著增强了 PFE 泄漏机制,导致总反向漏电流提升。
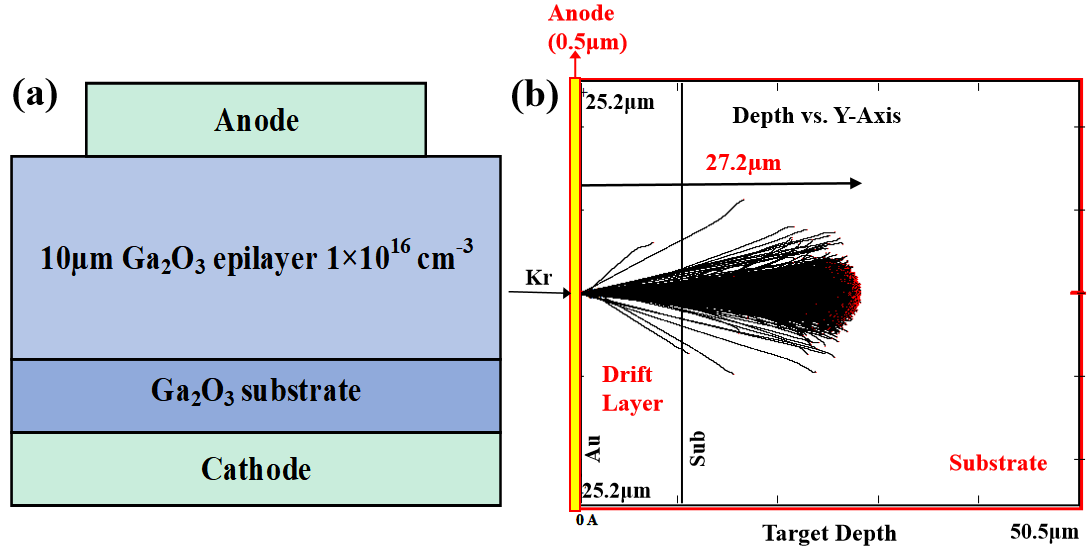
图1.(a)垂直 β-Ga2O3 肖特基二极管(SBD)结构示意图;(b)Kr 离子辐照在 β-Ga2O3 SBD 中造成的损伤分布模拟图。
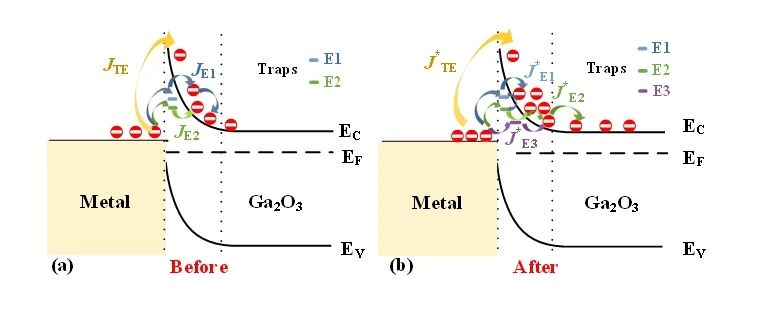
图2.(a)辐照前和(b)辐照后 β-Ga2O3 SBD 漏电机制对比图。
DOI:
doi.org/10.1063/5.0283627
本文转发自《亚洲氧化镓联盟》订阅号
